随着euv曝光技术的发展,半导体芯片也逐渐走向小型化,芯片之间的电极间隔变得更小。与此同时,芯片接收侧的封装基板的布线也变得越来越微小。
半导体基板具有多层结构,层与层之间的电信号通过在绝缘层钻出的微孔进行耦合。目前是通过用激光钻出约40微米的孔并应用金属镀层来完成层间布线的,但随着芯片的小型化发展,将来封装基板的孔径会减小到5微米及以下。
然而,以目前使用的激光加工技术,由于激光器和光学系统的特性,很难将光聚焦在小直径上,并且不可能钻出高纵横比的孔。因此,还需要一个适合微钻孔的薄绝缘层。
基于以上背景,近日,在美国丹佛举行的国际会议ectc2024(electronic components and technology conference)上,东京大学、味之素精细技术株式会社、三菱电机株式会社、spectronix株式会社等四所公司/机构发布了一项联合开发的新技术。
该技术是用于封装基板的 3 微米超精细激光钻孔技术,这对于下一代半导体制造的“后端工艺”是必不可少的。
如图1所示,将一部分铜线放置在玻璃基板上,并在其顶部制造3微米厚的堆积膜(abf)。从上方,使用duv激光打孔机在5微米的间隔间钻出直径为3微米的孔。如右图的电子显微照片所示,相较此前的技术,我们能够钻出一个小约一个量级的孔。
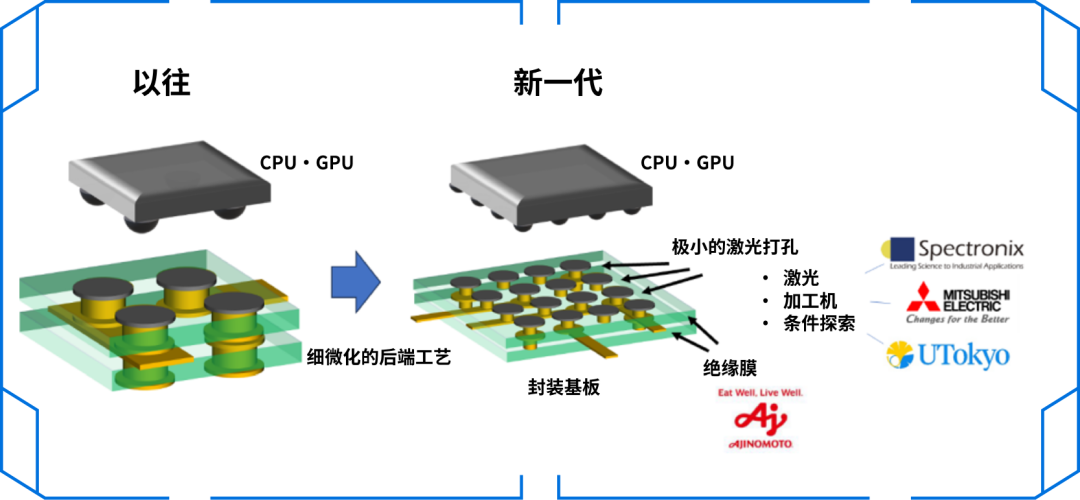
图1:从上方观察味之素组装薄膜(abf)上微孔的电子显微镜照片
东京大学将铜蒸镀在玻璃基板上,然后将铜激光加工成图案,来制成精细的铜线。味之素精细技术通过在铜布线层上层压薄膜 abf,在铜上形成3微米的绝缘层。spectronic负责波长为 266 纳米的 duv高功率激光器,而三菱电机则设计并改进了专门为深紫外线开发的激光加工机的光学系统,以减小光的聚焦尺寸。
东京大学通过活用ai人工智能的条件搜索结果,在不使用蚀刻技术的情况下能够在abf上制作一个直径为3微米的孔(图1右,图2右)。看图2右侧,可以看到只有abf有穿孔,下面的铜线和玻璃没有刮擦。使用这项技术,可以在电路板上高速制作任意钻孔图案。
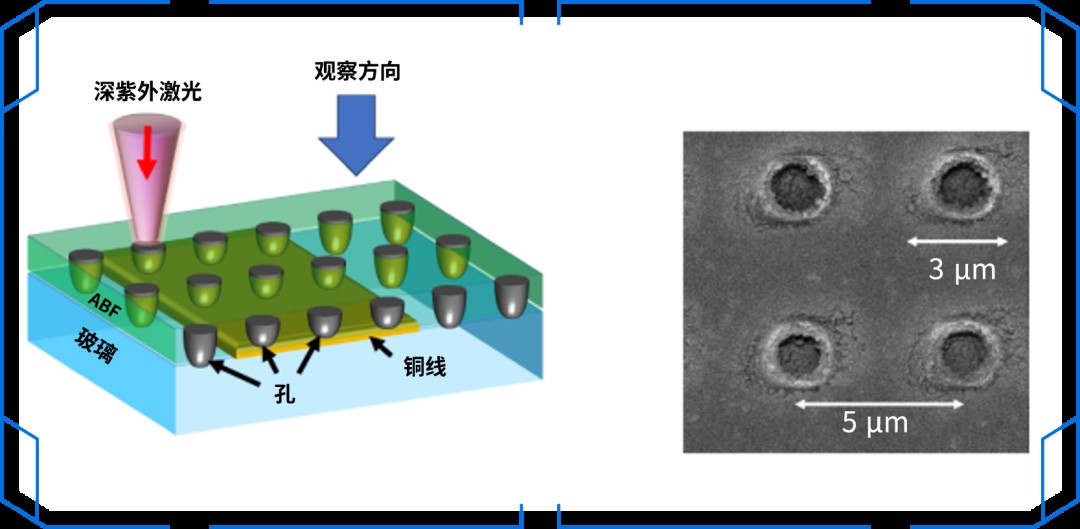
图2:制作的微孔截面的电子显微镜照片
这一成就是半导体产业后端路线图上的一个重要里程碑。通过证明使用激光加工机可以进行下一代微钻孔,发现可以以低成本进行高自由度的基板加工,从而实现半导体的进一步小型化。未来,我们计划将这项技术推广到主要的半导体制造商中。
- 中控技术上半年海外业务同比增188% 拟加码浙江人形机器人公司 2024-09-13
- 卡奥斯:托起中小企业数智化的信心和决心 2024-09-13
- 同行共赢丨海康机器人2024行业贝斯特全球最奢游戏最新的解决方案系列发布会,等您来乘风破浪 2024-09-13
- 天奇股份智能装备海外业务“红火” 人形机器人领域取得持续进展 2024-09-13
- 2024中国光伏绿色供应链大会,正泰新能“链”接全球 2024-09-13
- 光伏步入新一轮技术创新活跃期 2024-09-13
- 2024-09-13
- 竞速“人形机器人”万亿级新赛道 2024-09-13
- 第四届“中望杯”工业软件大赛圆满落幕 2024-09-13
- 中央首次系统部署全面绿色转型 实现碳中和需百万亿级投资 2024-09-13
- 灌区智能信息化管理系统 灌区续建节水配套改造项目 水库灌区信息化 2024-09-13
- 突破质检难题,华汉伟业视觉技术赋能耳机品质新飞跃 2024-09-13
- 2024-09-13
- 浩亭珠海:工业自动化的jizhi“连接” 2024-09-13
- 2024-09-13
贝斯特游戏的联系方式
- 电 话:0592-6372630
- 销售经理:兰顺长
- 手 机:18030129916
- 微 信:18030129916


